产品中心
每小时贴装高达46,000个倒装芯片
12"/8"晶圆扩张器
每小时处理高达30,000粘片元器件
扩片环处理能力
每小时(基准)处理高达126,500个 SMD元器件
助焊剂模块(LDU 2X)
支持的流程:倒装芯片、粘片、SMD贴装
具有自动晶圆切换功能的水平晶圆系统
处理0201公制的能力
多芯片能力
晶圆大小:4"-12"
水平系统
最大晶圆尺寸:12"
8"/12”晶圆扩张器
扩片环处理能力
晶圆图谱支持
自动晶圆切换
多芯片能力
最小芯片厚度:t ≥ 50 um(芯片)
芯片尺寸:0.5-15 mm
准确可靠的浸渍高度:
助焊剂厚度精度:±5 um
浸渍凹槽精度:±3.5 um
助焊剂加料传感器(可选)
可编程助焊剂平铺速度
可町编程浸渍停留时间
ASM西门子贴片机 SIPLACE CA
先进封装的最高精度
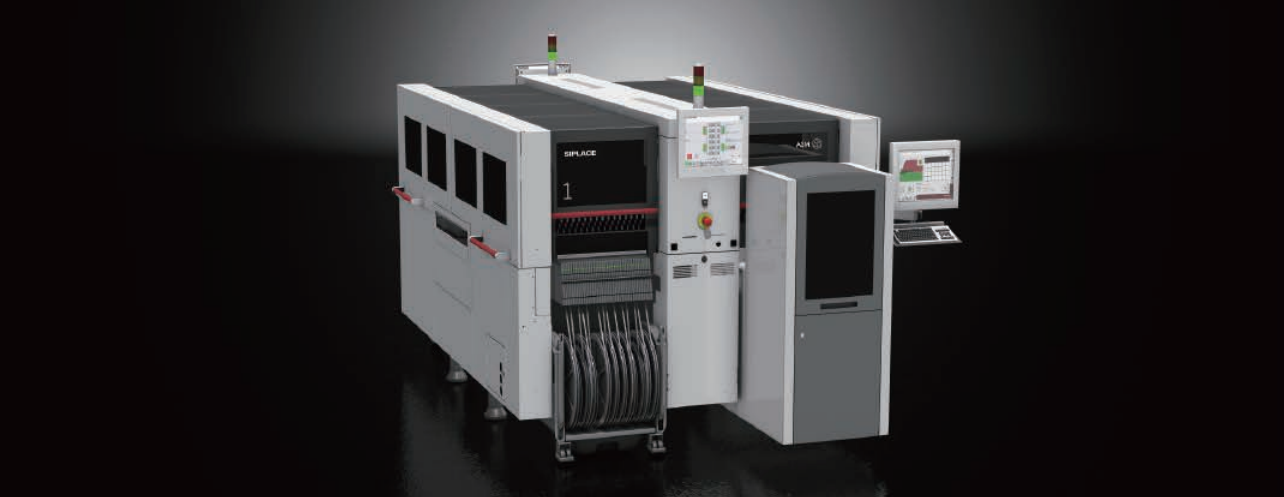
ASM西门子SIPLACE CA贴片机(芯片装配)平台使用粘片或者倒装芯片工艺直接贴装晶圆上的裸芯片。它支持SIPLACE×系列提供的所有SMT贴装功能。SIPLACECA能用于直接粘片或者全部SMD贴装,或可用于混合应用中,将裸芯片与SMD放在一个工序中贴装。
主要优势一览:
SIPLACE晶圆系统sws
SIPLACE晶圆系统(SWS)的集成使SIPLACE CA能够将标准SMT贴装流程,与直接贴装晶圆上的芯片的流程组合在一起。这一独特的单平台概念可支持直接粘片流程和倒装芯片流程。该平台的可扩展性可帮助优化不同封装如RF-MCM、FCIP、FC-MLF、FC-CSP的贴装成本。
低压力贴装
非接触式取料,非接触式贴装和0.5N贴装压力的特性,可以最小化敏感元器件/芯片的压力。
助焊剂模块(LDU 2 X)

SIPLACECA支持SWS和供料器交换台车之间的切换。新产品或者来料方式的改变(比如晶圆,供料器交换台车)可以被轻松适应。
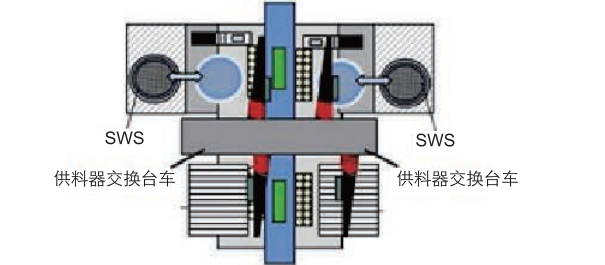
| ASM西门子SIPLACE CA配置 | |||
| SWS | 供料器交换台车 | 贴装工作头 | |
| SIPLACE CA4-4 | 4 | - | 4 |
| SIPLACE CA4-2 | 2 | 2 | 4 |
| SIPLACE CA4 | 0 | 4 | 4 |
| ASM西门子SIPLACE CA技术数据 | |||||
| 倒装芯片 | 粘片 | SMD | |||
| 精度 | 晶圆轨道传送带 | 面板轨道传送带 | 晶圆轨道传送带 | 面板轨道传送带 | |
| 士10um/3oa).b) | 士12um/3oa).b | 士10um/3oa).b) | 士12um/3oa).b | 士15um/3oa).b | |
| CPH (IPC)° | 46000(4个SWS) | 30000(4个SWS) | 126000(4个贴装工作头) | ||
| 芯片/元器件尺寸 | 0.5-15.0 mm | 0.8-15.0 mm(按需可至更小 | 0.11mm -15.0 mm | ||
| 最小芯片厚度(硅) | 50 um | 50 um | n/a | ||
| 最小凸块尺寸 | 25um | n/a | n/a | ||
| 最小凸块间距 | 50 um | n/a | n/a | ||
| SIPLACE晶圆系统SWS | 水平系统,自动晶圆切换,MCM | n/a | |||
| SWS晶圆尺寸 | 4"一12" | n/a | |||
| 晶圆扩张器 | 12"/8“(6"和4”可按需求配置) | n/a | |||
| 晶圆扩张范围 | 2 mm - 8 mm | n/a | |||
| 芯片顶针系统 | 可编程顶针速度 | n/a | |||
| 助焊剂模块LDU2 | 可编程顶针速度 | n/a | |||
| X助焊剂粘度 | 3,000- 100,000 cps | ||||
| 助焊剂厚度精 | ± 5 um | ||||
| 可编程键合力 | 0.5N-15.0N(取决于贴装头) | ||||
| 基板类型 | FR4, ceramics, flex,boats,8"/12”晶圆,其他 | ||||
| 基板厚度 | 0.3 mm - 4.5 mm | ||||
| 基板范围 | 50 x 50 mm - 685 x 650 mm(取决于传送带类型) | ||||
| 传送带类型 | 灵活双轨,单轨,晶圆和面板轨道传送带 | ||||
| 传输模式 | 同步,异步 | ||||
| 规格,采用SWS(WxDxH) | 3.938 m x 1.948 m x 1.893 m3 x 400 VAC~±5%; 50/6O Hz | ||||
| ASM西门子SIPLACE CA技术数据 | |||||
| 倒装芯片 | 粘片 | SMD | |||
| 精度 | 晶圆轨道传送带 | 面板轨道传送带 | 晶圆轨道传送带 | 面板轨道传送带 | |
| 士10um/3oa).b) | 士12um/3oa).b | 士10um/3oa).b) | 士12um/3oa).b | 士15um/3oa).b | |
| CPH (IPC)° | 46000(4个SWS) | 30000(4个SWS) | 126000(4个贴装工作头) | ||
| 芯片/元器件尺寸 | 0.5-15.0 mm | 0.8-15.0 mm(按需可至更小 | 0.11mm -15.0 mm | ||
| 最小芯片厚度(硅) | 50 um | 50 um | n/a | ||
| 最小凸块尺寸 | 25um | n/a | n/a | ||
| 最小凸块间距 | 50 um | n/a | n/a | ||
| SIPLACE晶圆系统SWS | 水平系统,自动晶圆切换,MCM | n/a | |||
| SWS晶圆尺寸 | 4"一12" | n/a | |||
| 晶圆扩张器 | 12"/8“(6"和4”可按需求配置) | n/a | |||
| 晶圆扩张范围 | 2 mm - 8 mm | n/a | |||
| 芯片顶针系统 | 可编程顶针速度 | n/a | |||
| 助焊剂模块LDU2 | 可编程顶针速度 | n/a | |||
| X助焊剂粘度 | 3,000- 100,000 cps | ||||
| 助焊剂厚度精 | ± 5 um | ||||
| 可编程键合力 | 0.5N-15.0N(取决于贴装头) | ||||
| 基板类型 | FR4, ceramics, flex,boats,8"/12”晶圆,其他 | ||||
| 基板厚度 | 0.3 mm - 4.5 mm | ||||
| 基板范围 | 50 x 50 mm - 685 x 650 mm(取决于传送带类型) | ||||
| 传送带类型 | 灵活双轨,单轨,晶圆和面板轨道传送带 | ||||
| 传输模式 | 同步,异步 | ||||
| 规格,采用SWS(WxDxH) | 3.938 m x 1.948 m x 1.893 m3 x 400 VAC~±5%; 50/6O Hz | ||||



